深入解析II|小手环也有“大心脏”?失效分析揭秘智能手环芯片
在上期我们抽丝剥茧,将完整的手环分别通过X-Ray、去塑封、截面研磨等手段将芯片逐步剥离出来,呈现其内部的结构。本期我们将通过DB-FIB(Dual-Beam Focus Ion Beam),精准地在芯片感兴趣位置(ROI)制备平整的切口,工程师们根据芯片内部的结构,判断芯片工艺流程是否符合设计要求,例如刻蚀深度和平整度、薄膜厚度和粗糙度、金属填充致密性等,抑或能够在微观尺度上进行精确的“手术”,修改电路的走向,无须复杂的工艺流程就能改变芯片的电路逻辑,当然也可以在遇到芯片失效时,针对性地在纳米尺度对芯片局部作显微失效分析。

首先回顾一下我们今天的两位“主角”:
主控芯片:
AMA3B是Ambiq Micro公司发布的一款自带超低功耗蓝牙模块的MCU芯片。该器件采用ARM Cortex M4F内核,运行频率高达96 MHz。SoC配置了1 MB的闪存,384 KB的SRAM和16 KB的缓存,在微型可穿戴设备上应用十分广泛。工艺节点40nm,由TSMC代工,属于成熟制程。
存储芯片:
GD25LQ256DWIGR是来自国内某主流存储器件生产商的NOR Flash,256M位串行闪存,32M字节,每个可编程页面256字节。工艺节点55 nm,同属于成熟制程。
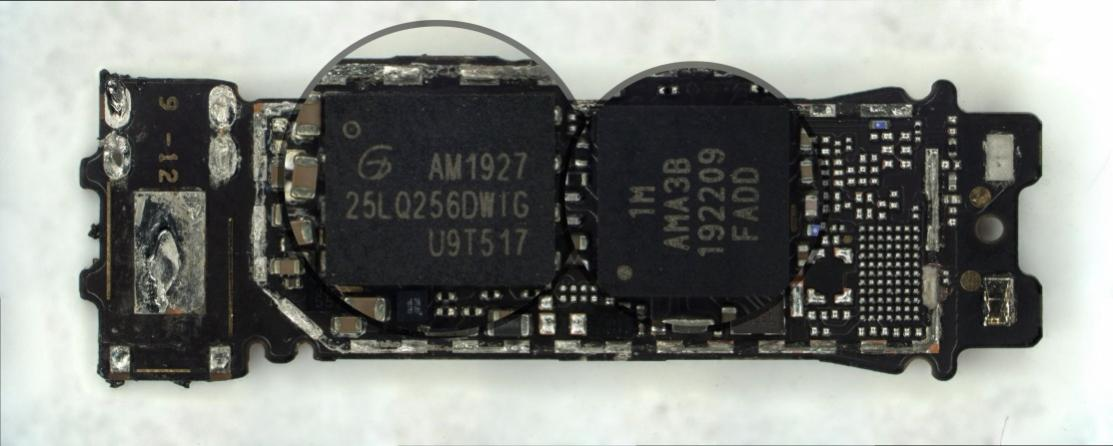
本案使用的主要设备是DB-FIB,工作原理是将液态金属镓离子源产生的离子束经过离子枪加速、聚焦后照射于样品表面实现成像、切割、注入以及沉积。通过这一系列操作,我们可以完成半导体分析中必备的截面切割分析、TEM样品制备、线路修补等分析手段。本次使用的设备是来自蔡司的Cross Beam 550,清晰的分辨率以及超高的切抛效率帮助我们迅速准确地完成样品制备和电子显微分析。
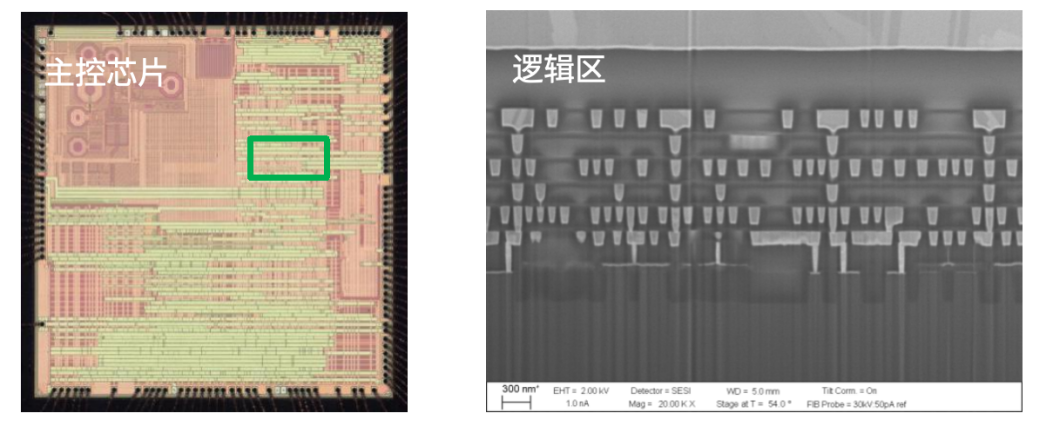
如上图,是主控芯片逻辑区域用FIB切出的截面效果,相较于传统机械研磨更加平整,且非晶损伤小,在便于观测的同时也提供了更精准的定位(平面或垂直方向)。
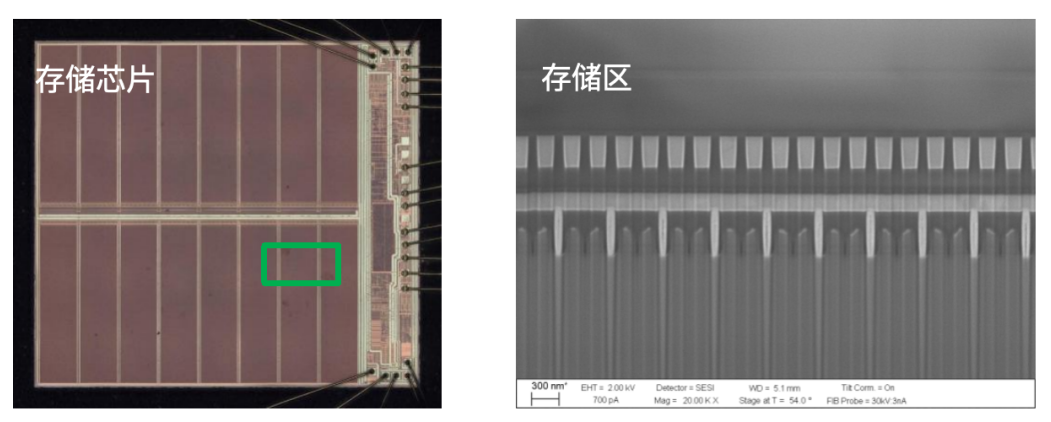
对于存储芯片,可以通过截面的SEM 清晰地观察到M2,M1,Contact以及Control gate的微观结构。但由于metal line的“窗帘效应”,如需对衬底表面的floating gate做更细致地观测,可以采用lift-out工艺倒置切割后观测。除此以外,利用FIB/SEM,也可以协助进一步探究表带在日常佩戴过程中是否会析出不利于身体健康的成分,可以利用OM和SEM在不同倍率下观察硅胶表带的表面,看看经过长时间佩戴之后是否有异常残留物,也可以使用EDS能谱进行化学组分分析。
OM分析:
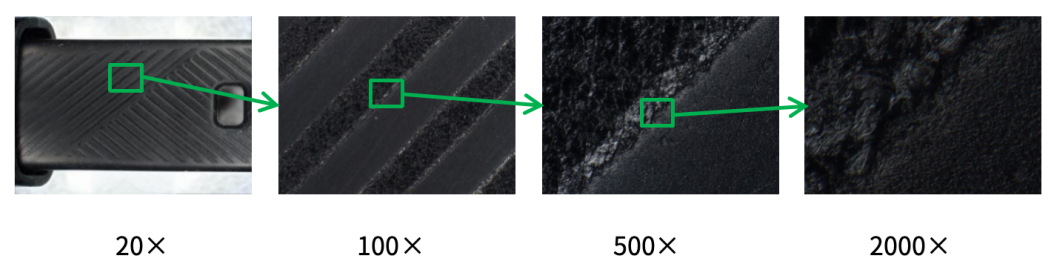
SEM分析:
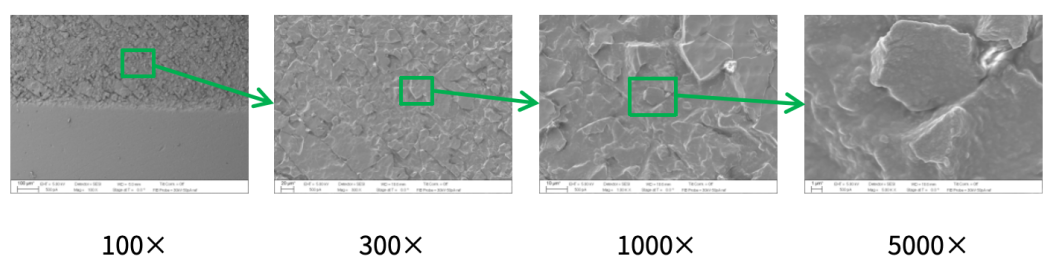
SEM/EDS分析:
在电子显微镜下,我们先进行了不同倍率的形貌观察,后续采集了X射线能谱,检测到表面只有C、O、Si等硅胶常见元素,而Cl可能来自人体分泌的汗液残留。


通过使用EDS能谱,我们可以获知样品中存在的元素,并且通过进一步的谱图分析,可以半定量获取元素含量和分布情况。这在半导体分析中是至关重要的,经验丰富的工程师根据异常出现的位置及元素种类,判定位半导体工艺流程中可能出现的各类问题。
失效分析是检测芯片可靠性的关键步骤,它可以帮助我们识别芯片失效的根本原因,对于保证产品可靠性、优化生产流程、降低维修成本以及预防未来类似问题具有重要意义。CTI华测检测可提供拥有完善的芯片、半导体器件失效分析工具,可提供完善的失效分析服务,测试数据准确可靠。同时,CTI拥有完备的实验室信息管理系统,能够保障每个服务环节的高效、保密运转,为客户提供专业、便捷的检测分析服务。
CTI华测检测定制化DPA方案|助力企业把关芯片质量
市场竞争日益激烈,产品质量是企业获取竞争优势的重要因素之一。芯片作为产品的“大脑”、设备的核心,芯片质量的好坏将对产品的质量、性能产生至关重要的影响。
2024-01-22 02:04:49
CTI华测检测诚邀您出席半导体高功耗芯片测试能力宣讲会
伴随着国内科技的不断发展,我们对芯片功能的要求也在不断的提高,芯片内部的晶体管也越来越多,功耗越来越高,本次华测半导体芯片研讨会主要针对大功耗AECQ项目及失效分析和硬件测试方面和各位来宾进行深入探讨。在此,我们诚邀您出席,衷心感谢您的支持与指导。
2023-12-05 23:56:41
干货-车用芯片AEC-Q验证常见问题解答
随着汽车电子朝着智能化、信息化、网络化方向发展,汽车芯片正迎来新的发展机遇,车用芯片AEC-Q验证常遇到的问题有哪些?
2022-02-07 07:46:34
- 热线电话
- 业务咨询
- 快速询价
- 在线客服
- 报告验证





