芯片器件不发光发热,用什么检测设备找热点?
失效点定位方式是IC器件通电后会产生电流,侦测到在异常缺陷的IC电流差异产生的光子激发与热辐射,即能定位到此缺陷的位置;但有些情况下,这些电流差异并不会有明显的光子激发与热辐射发生,如金属桥接造成的欧姆短路,空孔造成的电阻值变大等机制;因此EMMI和Thermal EMMI并不能有效侦测到这些缺陷机制所产生的讯号。
如同医生看诊,若无法由病患本身发出的征状找出问题点,医生可转换成触诊模式,如按压身体部位,当病患对按压的点有任何异常反应时,即可判断该位置有异常可能。
IC器件也可以用相同的原理进行,利用激光束在IC表面扫描作微区加热,若某个加热的微区造成IC在通电状态下的电流或电压有改变异常,即可判断该微区有异常可能。这项技术就是OBIRCH(激光束电阻异常侦测),机台外观如下图所示。

OBIRCH技术原理
OBIRCH是利用激光束在IC表面扫描作微区加热,激光束会造成扫描区区域内的材料被加热。若IC中存在缺陷因其材质电阻温度系数不同于其它的完整区域,则该区会引起的温度变化会不同,而温度变化会造成电阻值增加或降低的现象(ΔR)。如果在扫描同时对样品特定电路施加定电压,则可侦测到电流变化关系为ΔI=(ΔR/R)I。将激光加热引起的电阻变化导致电流变化,记录该位置与通过激光束扫描芯片产生的影像图重叠,即可做出定位。如下图说明:
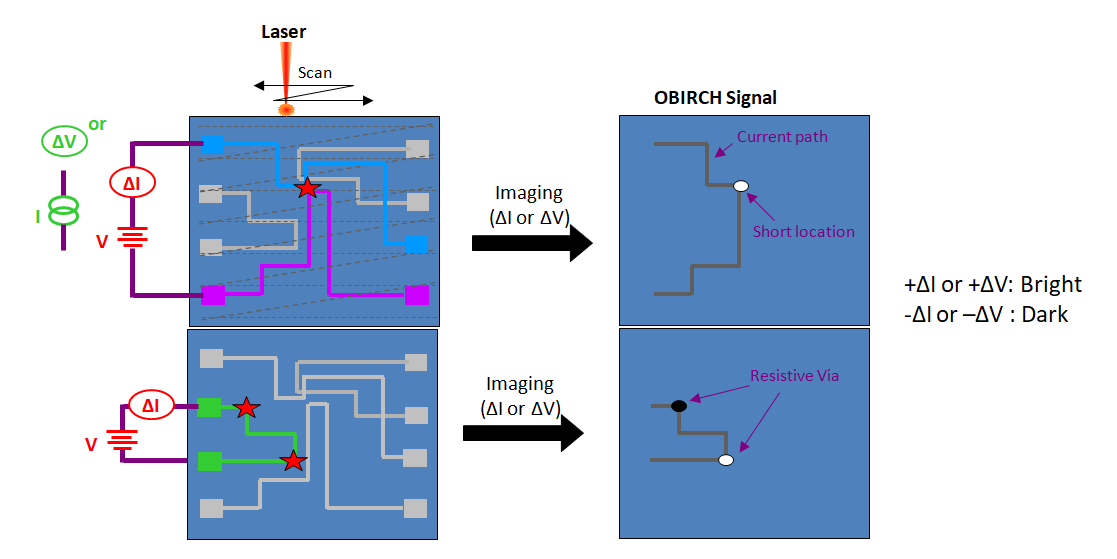
背向式OBIRCH的优势
在OBIRCH测量中,通常使用波长为1.34µm的激光束,这激光的能量低于Si带隙(Eg=1.12 eV),因此产生电子-空穴对的可能性低,因此于硅材质中激光的衰减很弱(相对是透明的状态),有助于光到热的转换而发生吸收,因此电子-空穴对感应出的光电流是对OBIRCH信号的强噪声。另一方面,激光在硅材质中相对是透明的状态,有助于背向式加热分析。
当错综复杂和线宽大的金属接线阻挡激光进入比较底层线路,则加热的机制无法精确作用,因此缺陷位置无法侦测到,这状况下则建议进行背向式分析,以避开多层金属线的阻挡。
华测蔚思博检测配备领先业界的背向式OBIRCH装置,针对现在普遍使用的FCBGA和WLCSP封装,不需要经过额外的打线作业,即可进行分析,节省时间及费用。
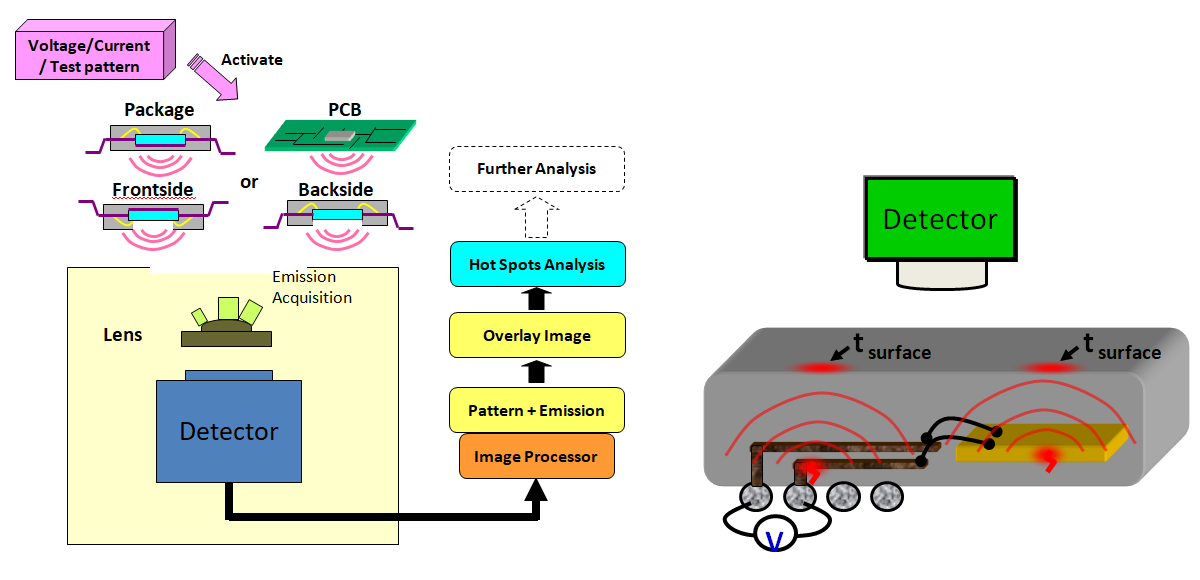

如何解读OBIRCH的亮暗对比讯息
客户对OBIRCH的技术原理并不陌生,但对于数据的亮暗对比常有疑问,因此我们解释亮暗对比的成因:
材料的电阻温度系数有正与负的区别,电阻的正温度系数(αTCR>0)是指材料在一定温度范围内的电阻值会随温度上升而上升,如一般的金属材料;电阻负温度系数(αTCR<0)是指其电阻值随温度升高而降低,如半导体、绝缘体的电阻值都随温度上升而下降。
αTCR>0代表材料吸热后电阻值会上升(ΔR>0)导致电流(ΔI<0)会下降,因此呈现暗的对比;反之αTCR<0代表材料吸热后电阻值会下降(ΔR<0),导致电流会上升(ΔI>0)因此呈现亮的对比,如下图所描述。

OBIRCH应用领域
OBIRCH是一种非常强大的集成电路故障定位技术。在半导体故障分析中,OBIRCH通常用于定位芯片内部高阻抗及低阻抗分析,是发光显微技术的有力互补分析工具。
·短路/桥接:Interconnection(Metal or poly)的桥接;线路或组件的烧毁产生短路。
·漏电:栅极氧化层缺陷(Gate Oxide Pin Hole);P-N界面漏电或崩溃;界面/阱漏电。
·高阻抗:Interconnection(Metal or poly)的孔洞/Contact or via孔洞或底部阻值异常;线路或组件的烧毁产生线路残留。
OBIRCH具有高分辨能力,其测试精度可达nA级。搭配进行背向式分析,即可快速针对FCBGA和WLCSP封装进行分析,节省时间及费用外,更可减低试样打线过程中的风险。
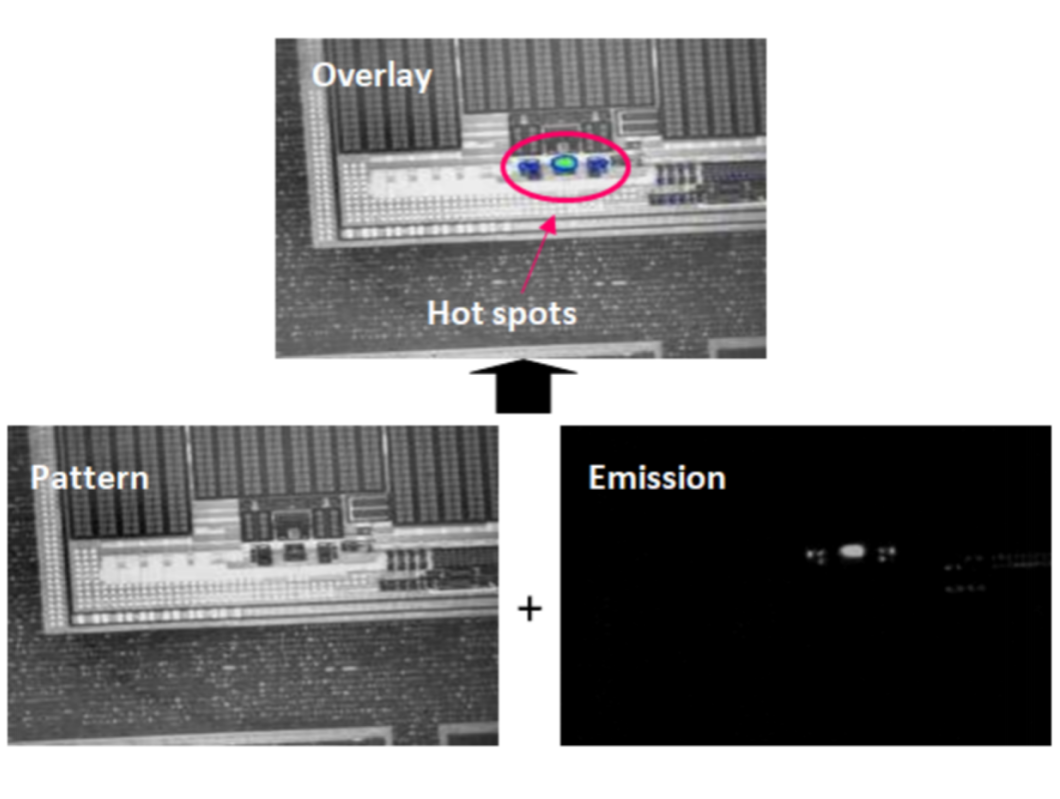
CTI华测检测定制化DPA方案|助力企业把关芯片质量
市场竞争日益激烈,产品质量是企业获取竞争优势的重要因素之一。芯片作为产品的“大脑”、设备的核心,芯片质量的好坏将对产品的质量、性能产生至关重要的影响。
2024-01-22 02:04:49
CTI华测检测诚邀您出席半导体高功耗芯片测试能力宣讲会
伴随着国内科技的不断发展,我们对芯片功能的要求也在不断的提高,芯片内部的晶体管也越来越多,功耗越来越高,本次华测半导体芯片研讨会主要针对大功耗AECQ项目及失效分析和硬件测试方面和各位来宾进行深入探讨。在此,我们诚邀您出席,衷心感谢您的支持与指导。
2023-12-05 23:56:41
干货-车用芯片AEC-Q验证常见问题解答
随着汽车电子朝着智能化、信息化、网络化方向发展,汽车芯片正迎来新的发展机遇,车用芯片AEC-Q验证常遇到的问题有哪些?
2022-02-07 07:46:34
- 热线电话
- 业务咨询
- 快速询价
- 在线客服
- 报告验证





